-
In the etching process, a bias source is usually applied to the substrate of the inductively coupled plasma (ICP) to realize independent modulation of the ion energy and ion flux. In this work, a hybrid model, i.e. a global model combined bi-directionally with a fluid sheath model, is employed to investigate the plasma properties and ion energy distribution function (IEDF) in biased inductively coupled Ar/O2/Cl2 plasmas. The results indicate that at a bias frequency of 2.26 MHz, the Cl– ion density and ClO+ ion density first increase with bias voltage rising, and then they decrease, and finally they rise again, which is different from the densities of other charged species, such as O and Cl atoms. At the bias frequency of 13.56 MHz and 27.12 MHz, except Cl– and
$ {\text{Cl}}_2^ + $ ions, the evolutions of other species densities with bias voltage are similar to the results at lower bias frequency. The evolution of the species densities with bias frequency depends on the bias voltage. For instance, in the low bias voltage range (< 200 V), the densities of charges species, O and Cl atoms increase with bias frequency increasing due to a significant increase in the heating of the plasma by the bias source. However, when the bias voltage is high, say, higher than 300 V, except$ {\text{Cl}}_2^ + $ and Cl– ions, the densities of other charged species, O and Cl atoms first decrease with bias frequency increasing and then they increase due to a decrease and then an increase in the heating of the plasma by the bias source. In addition, as the bias frequency increases, the peak separation of IEDF becomes narrow, the high energy peak and low energy peak approach each other and they almost merge into one peak at high bias frequency. The results obtained in this work are of significant importance in improving the etching process.-
Keywords:
- inductively coupled plasma /
- bias source /
- hybrid model /
- ion energy /
- ion flux
[1] Efremov A M, Kim D P, Kim C I 2004 IEEE Trans. Plasma Sci. 32 1344
 Google Scholar
Google Scholar
[2] Efremov A M, Kim D P, Kim C I 2003 J. Vac. Sci. Technol., A 21 1568
 Google Scholar
Google Scholar
[3] Bogaerts A, Neyts E, Gijbels R, Van Der Mullen J 2002 Spectrochim Acta, Part B 57 609
 Google Scholar
Google Scholar
[4] Choi S K, Kim D P, Kim C I, Chang E G 2001 J. Vac. Sci. Technol., A 19 1063
 Google Scholar
Google Scholar
[5] Lee Y J, Han H R, Lee J, Yeom G Y 2000 Surf. Coat. Technol. 131 257
 Google Scholar
Google Scholar
[6] Wen D Q, Liu W, Gao F, Lieberman M A, Wang Y N 2016 Plasma Sources Sci. Technol. 25 045009
 Google Scholar
Google Scholar
[7] Wen D, Zhang Y, Lieberman M A, Wang Y 2017 Plasma Processes Polym. 14 1600100
 Google Scholar
Google Scholar
[8] Zhang Y R, Gao F, Li X C, Bogaerts A, Wang Y N 2015 J. Vac. Sci. Technol., A 33 061303
 Google Scholar
Google Scholar
[9] Lee H C, Lee M H, Chung C W 2010 Appl. Phys. Lett. 96 071501
 Google Scholar
Google Scholar
[10] Lee H C, Chung C W 2012 Appl. Phys. Lett. 101 244104
 Google Scholar
Google Scholar
[11] Lee H C, Bang J Y, Chung C W 2011 Thin Solid Films 519 7009
 Google Scholar
Google Scholar
[12] Lee C, Lieberman M A 1995 J. Vac. Sci. Technol., A 13 368
 Google Scholar
Google Scholar
[13] Gudmundsson J T 2004 J. Phys. D: Appl. Phys. 37 2073
 Google Scholar
Google Scholar
[14] Jung J, Kim M S, Park J, Lim C M, Hwang T W, Seo B J, Chung C W 2023 Phys. Plasmas 30 023504
 Google Scholar
Google Scholar
[15] Tong L, Zhang Y R, Huang J W, Zhao M L, Wen D Q, Song Y H, Wang Y N 2021 Phys. Plasmas 28 053512
 Google Scholar
Google Scholar
[16] Tong L, Zhao M L, Zhang Y R, Song Y H, Wang Y N 2023 J. Phys. D: Appl. Phys. 56 365202
[17] Khater M H, Overzet L J 2004 Plasma Sources Sci. Technol. 13 466
 Google Scholar
Google Scholar
[18] Dai Z L, Zhang S Q, Wang Y N 2013 Vacuum 89 197
 Google Scholar
Google Scholar
[19] Zhang S Q, Dai Z L, Song Y H, Wang Y N 2014 Vacuum 99 180
 Google Scholar
Google Scholar
[20] Levko D, Raja L L 2022 J. Vac. Sci. Technol., B 40 052205
 Google Scholar
Google Scholar
[21] Levko D, Upadhyay R R, Suzuki K, Raja L L 2023 J. Vac. Sci. Technol., A 41 012205
 Google Scholar
Google Scholar
[22] Malyshev M V, Donnelly V M, Colonell J I, Samukawa S 1999 J. Appl. Phys. 86 4813
 Google Scholar
Google Scholar
[23] Malyshev M V, Donnelly V M 2000 Plasma Sources Sci. Technol. 9 353
 Google Scholar
Google Scholar
[24] Donnelly V M, Malyshev M V 2000 Appl. Phys. Lett. 77 2467
 Google Scholar
Google Scholar
[25] Malyshev M V, Donnelly V M 2001 J. Appl. Phys. 90 1130
 Google Scholar
Google Scholar
[26] Malyshev M V, Fuller N C M, Bogart K H A, Donnelly V M, Herman I P 2000 J. Appl. Phys. 88 2246
 Google Scholar
Google Scholar
[27] Malyshev M V, Donnelly V M 2000 J. Appl. Phys. 88 6207
 Google Scholar
Google Scholar
[28] Malyshev M V, Donnelly V M 2000 J. Appl. Phys. 87 1642
 Google Scholar
Google Scholar
[29] Thorsteinsson E G, Gudmundsson J T 2010 Plasma Sources Sci. Technol. 19 015001
 Google Scholar
Google Scholar
[30] Thorsteinsson E G, Gudmundsson J T 2010 J. Phys. D: Appl. Phys. 43 115201
 Google Scholar
Google Scholar
[31] Thorsteinsson E G, Gudmundsson J T 2010 J. Phys. D: Appl. Phys. 43 115202
 Google Scholar
Google Scholar
[32] Thorsteinsson E G, Gudmundsson J T 2010 Plasma Sources Sci. Technol. 19 055008
 Google Scholar
Google Scholar
[33] Gudmundsson J T, Hjartarson A T, Thorsteinsson E G 2012 Vacuum 86 808
 Google Scholar
Google Scholar
[34] Zhang Y R, Zhao Z Z, Xue C, Gao F, Wang Y N 2019 J. Phys. D: Appl. Phys. 52 295204
[35] Liu W, Wen D Q, Zhao S X, Gao F, Wang Y N 2015 Plasma Sources Sci. Technol. 24 025035
 Google Scholar
Google Scholar
[36] 范惠泽, 刘凯, 黄永清, 蔡世伟, 任晓敏, 段晓峰, 王琦, 刘昊, 吴瑶, 费嘉瑞 2017 真空科学与技术学报 37 286
 Google Scholar
Google Scholar
Fan H Z, Liu K, Huang Y Q, Cai S W, Ren X M, Duan X F, Wang Q, Liu H, Wu Y, Fei J R 2017 Chin. J. Vac. Sci. Technol. 37 286
 Google Scholar
Google Scholar
[37] Smith S A, Lampert W V, Rajagopal P, Banks A D, Thomson D, Davis R F 2000 J. Vac. Sci. Technol., A 18 879
 Google Scholar
Google Scholar
[38] Lee J M, Chang K M, Lee I H, Park S J 2000 J. Vac. Sci. Technol., B 18 1409
 Google Scholar
Google Scholar
[39] Taube A, Kamiński M, Ekielski M, et al. 2021 Mater. Sci. Semicond. Process. 122 105450
 Google Scholar
Google Scholar
[40] Chung C W, Chung I 2000 J. Vac. Sci. Technol., A 18 835
 Google Scholar
Google Scholar
[41] Park J S, Kim T H, Choi C S, Hahn Y B 2002 Korean J. Chem. Eng. 19 486
 Google Scholar
Google Scholar
[42] Kwon K H, Efremov A, Yun S J, Chun I, Kim K 2014 Thin Solid Films 552 105
 Google Scholar
Google Scholar
[43] Kang S, Efremov A, Yun S J, Son J, Kwon K H 2013 Plasma Chem. Plasma Process. 33 527
 Google Scholar
Google Scholar
[44] Tinck S, Boullart W, Bogaerts A 2009 J. Phys. D: Appl. Phys. 42 095204
 Google Scholar
Google Scholar
[45] Tinck S, Boullart W, Bogaerts A 2011 Plasma Sources Sci. Technol. 20 045012
 Google Scholar
Google Scholar
[46] Tinck S, Bogaerts A, Shamiryan D 2011 Plasma Processes Polym. 8 490
 Google Scholar
Google Scholar
[47] Hsu C C, Coburn J W, Graves D B 2006 J. Vac. Sci. Technol., A 24 1
 Google Scholar
Google Scholar
[48] Efremov A, Amirov I, Izyumov M 2023 Vacuum 207 111664
 Google Scholar
Google Scholar
[49] Hsu C C, Nierode M A, Coburn J W, Graves D B 2006 J. Phys. D: Appl. Phys. 39 3272
 Google Scholar
Google Scholar
[50] Schulze J, Schüngel E, Czarnetzki U 2012 Appl. Phys. Lett. 100 024102
 Google Scholar
Google Scholar
[51] Ahr P, Schüngel E, Schulze J, Tsankov T V, Czarnetzki U 2015 Plasma Sources Sci. Technol. 24 044006
 Google Scholar
Google Scholar
[52] Lieberman M A, Lichtenberg A J 2005 Principles of Plasma Discharges and Materials Processing (Hoboken, NJ, USA: John Wiley & Sons, Inc.) p268
[53] 张钰如, 高飞, 王友年 2021 70 095206
 Google Scholar
Google Scholar
Zhang Y R, Gao F, Wang Y N A 2021 Acta Phys. Sin. 70 095206
 Google Scholar
Google Scholar
[54] Yang W, Zhao S X, Wen D Q, Liu W, Liu Y X, Li X C, Wang Y N 2016 J. Vac. Sci. Technol., A 34 031305
 Google Scholar
Google Scholar
[55] Toneli D A, Pessoa R S, Roberto M, Gudmundsson J T 2015 J. Phys. D: Appl. Phys. 48 325202
 Google Scholar
Google Scholar
[56] Proto A 2021 Ph. D. Dissertation (Iceland: University of Iceland
[57] Stafford L, Khare R, Guha J, Donnelly V M, Poirier J S, Margot J 2009 J. Phys. D: Appl. Phys. 42 055206
 Google Scholar
Google Scholar
[58] Guha J, Donnelly V M 2009 J. Appl. Phys. 105 113307
 Google Scholar
Google Scholar
[59] Boyd R L F, Thomson J B 1959 Proc. R. Soc. London, Ser. A 252 102
 Google Scholar
Google Scholar
[60] Kokkoris G, Goodyear A, Cooke M, Gogolides E 2008 J. Phys. D: Appl. Phys. 41 195211
 Google Scholar
Google Scholar
[61] Dai Z L, Wang Y N, Ma T C 2002 Phys. Rev. E 65 036403
 Google Scholar
Google Scholar
[62] Dai Z L, Wang Y N 2004 Phys. Rev. E 69 036403
 Google Scholar
Google Scholar
[63] Dai Z L, Wang Y N 2002 Phys. Rev. E 66 026413
 Google Scholar
Google Scholar
[64] Dai Z L, Wang Y N 2002 J. Appl. Phys. 92 6428
 Google Scholar
Google Scholar
[65] Dai Z L, Wang Y N 2003 Surf. Coat. Technol. 165 224
 Google Scholar
Google Scholar
[66] Wen D Q, Zhang Q Z, Jiang W, Song Y H, Bogaerts A, Wang Y N 2014 J. Appl. Phys. 115 233303
 Google Scholar
Google Scholar
[67] Hong Y H, Kim T W, Kim B S, Lee M Y, Chung C W 2022 Plasma Sources Sci. Technol. 31 075008
 Google Scholar
Google Scholar
[68] Huang S, Gudmundsson J T 2013 Plasma Sources Sci. Technol. 22 055020
 Google Scholar
Google Scholar
[69] Hennad A, Yousfi M 2010 J. Phys. D: Appl. Phys. 44 025201
 Google Scholar
Google Scholar
[70] Manenschijn A, Janssen G C A M, Van Der Drift E, Radelaar S 1991 J. Appl. Phys. 69 1253
 Google Scholar
Google Scholar
[71] Hayden C, Gahan D, Hopkins M B 2009 Plasma Sources Sci. Technol. 18 025018
 Google Scholar
Google Scholar
[72] Gahan D, Dolinaj B, Hopkins M B 2008 Rev. Sci. Instrum. 79 033502
 Google Scholar
Google Scholar
[73] Edelberg E A, Aydil E S 1999 J. Appl. Phys. 86 4799
 Google Scholar
Google Scholar
[74] Edelberg E A, Perry A, Benjamin N, Aydil E S 1999 J. Vac. Sci. Technol., A 17 506
 Google Scholar
Google Scholar
[75] Edelberg E A, Perry A, Benjamin N, Aydil E S 1999 Rev. Sci. Instrum. 70 2689
 Google Scholar
Google Scholar
-
图 5 不同偏压频率下, 带电粒子密度随偏压幅值的变化 (a) Ar+; (b) $ {\text{O}}_2^ + $; (c) O+; (d) O–; (e) $ {\text{Cl}}_2^ + $; (f) Cl+; (g) Cl–; (h) ClO+; (i) 电子密度
Figure 5. Evolutions of the densities of charged species with bias voltage for different bias frequencies: (a) Ar+; (b) $ {\text{O}}_2^ + $; (c) O+; (d) O–; (e) $ {\text{Cl}}_2^ + $; (f) Cl+; (g) Cl–; (h) ClO+; (i) electron density.
表 1 Ar/O2/Cl2混合气体放电中考虑的粒子
Table 1. Plasma species considered in Ar/O2/Cl2 discharges.
基态中性粒子 Ar, O2, O3, O, Cl2 (ν = 0), Cl, ClO 激发态中性
粒子Arm, Arr, Ar(4p), O2(a), O(D),
Cl2 (ν = 1), Cl2 (ν = 2), Cl2 (ν = 3)正离子 Ar+, $ {\text{O}}_2^ + $, O+, $ {\text{Cl}}_2^ + $, Cl+, ClO+ 负离子/电子 O–, Cl–, e No. Reaction ${\gamma _l}$ 1 ${\text{Cl + wall }} \to {\text{ }}\dfrac{{1}}{{2}}{\text{C}}{{\text{l}}_{2}}\left( {\nu = {0}} \right)$ 方程(3) 2 ${\text{Cl + wall }} \to {\text{ }}\dfrac{{1}}{{2}}{\text{ClO}}$ 方程(4) 3 ${\text{O + wall }} \to {\text{ }}\dfrac{{1}}{{2}}{{\text{O}}_{2}}$ 0.09 4 ${\text{O}}\left( {\text{D}} \right){\text{ + wall }} \to {\text{ }}\dfrac{{1}}{{2}}{{\text{O}}_{2}}$ 0.09 5 ${\text{C}}{{\text{l}}_{2}}\left( \nu \right){\text{ + wall }} \to {\text{ C}}{{\text{l}}_{2}}\left( {\nu - {1}} \right)$ 1 6 ${{\text{O}}_{2}}\left( {\text{a}} \right){\text{ + wall }} \to {\text{ }}{{\text{O}}_{2}}$ 0.007 7 ${\text{O}}\left( {\text{D}} \right){\text{ + wall }} \to {\text{ O}}$ 0.1 8 ${\text{A}}{{\text{r}}^ * }{\text{ + wall }} \to {\text{ Ar}}$ 1 表 3 偏压频率为13.56 MHz时, 不同偏压幅值下的时间平均鞘层厚度和鞘层电压降
Table 3. Time-averaged sheath thickness and voltage drop across the sheath for different bias voltage amplitudes, at bias frequency of 13.56 MHz.
25 V 50 V 75 V 100 V 125 V 150 V 175 V 200 V ${\bar d_{\text{s}}}{\text{ /mm}}$ 4.67 4.75 4.79 4.80 4.81 4.85 4.93 5.03 ${\bar V_{\text{s}}}{\text{ /V}}$ 31.32 55.47 79.98 104.63 129.34 154.1 178.88 203.70 -
[1] Efremov A M, Kim D P, Kim C I 2004 IEEE Trans. Plasma Sci. 32 1344
 Google Scholar
Google Scholar
[2] Efremov A M, Kim D P, Kim C I 2003 J. Vac. Sci. Technol., A 21 1568
 Google Scholar
Google Scholar
[3] Bogaerts A, Neyts E, Gijbels R, Van Der Mullen J 2002 Spectrochim Acta, Part B 57 609
 Google Scholar
Google Scholar
[4] Choi S K, Kim D P, Kim C I, Chang E G 2001 J. Vac. Sci. Technol., A 19 1063
 Google Scholar
Google Scholar
[5] Lee Y J, Han H R, Lee J, Yeom G Y 2000 Surf. Coat. Technol. 131 257
 Google Scholar
Google Scholar
[6] Wen D Q, Liu W, Gao F, Lieberman M A, Wang Y N 2016 Plasma Sources Sci. Technol. 25 045009
 Google Scholar
Google Scholar
[7] Wen D, Zhang Y, Lieberman M A, Wang Y 2017 Plasma Processes Polym. 14 1600100
 Google Scholar
Google Scholar
[8] Zhang Y R, Gao F, Li X C, Bogaerts A, Wang Y N 2015 J. Vac. Sci. Technol., A 33 061303
 Google Scholar
Google Scholar
[9] Lee H C, Lee M H, Chung C W 2010 Appl. Phys. Lett. 96 071501
 Google Scholar
Google Scholar
[10] Lee H C, Chung C W 2012 Appl. Phys. Lett. 101 244104
 Google Scholar
Google Scholar
[11] Lee H C, Bang J Y, Chung C W 2011 Thin Solid Films 519 7009
 Google Scholar
Google Scholar
[12] Lee C, Lieberman M A 1995 J. Vac. Sci. Technol., A 13 368
 Google Scholar
Google Scholar
[13] Gudmundsson J T 2004 J. Phys. D: Appl. Phys. 37 2073
 Google Scholar
Google Scholar
[14] Jung J, Kim M S, Park J, Lim C M, Hwang T W, Seo B J, Chung C W 2023 Phys. Plasmas 30 023504
 Google Scholar
Google Scholar
[15] Tong L, Zhang Y R, Huang J W, Zhao M L, Wen D Q, Song Y H, Wang Y N 2021 Phys. Plasmas 28 053512
 Google Scholar
Google Scholar
[16] Tong L, Zhao M L, Zhang Y R, Song Y H, Wang Y N 2023 J. Phys. D: Appl. Phys. 56 365202
[17] Khater M H, Overzet L J 2004 Plasma Sources Sci. Technol. 13 466
 Google Scholar
Google Scholar
[18] Dai Z L, Zhang S Q, Wang Y N 2013 Vacuum 89 197
 Google Scholar
Google Scholar
[19] Zhang S Q, Dai Z L, Song Y H, Wang Y N 2014 Vacuum 99 180
 Google Scholar
Google Scholar
[20] Levko D, Raja L L 2022 J. Vac. Sci. Technol., B 40 052205
 Google Scholar
Google Scholar
[21] Levko D, Upadhyay R R, Suzuki K, Raja L L 2023 J. Vac. Sci. Technol., A 41 012205
 Google Scholar
Google Scholar
[22] Malyshev M V, Donnelly V M, Colonell J I, Samukawa S 1999 J. Appl. Phys. 86 4813
 Google Scholar
Google Scholar
[23] Malyshev M V, Donnelly V M 2000 Plasma Sources Sci. Technol. 9 353
 Google Scholar
Google Scholar
[24] Donnelly V M, Malyshev M V 2000 Appl. Phys. Lett. 77 2467
 Google Scholar
Google Scholar
[25] Malyshev M V, Donnelly V M 2001 J. Appl. Phys. 90 1130
 Google Scholar
Google Scholar
[26] Malyshev M V, Fuller N C M, Bogart K H A, Donnelly V M, Herman I P 2000 J. Appl. Phys. 88 2246
 Google Scholar
Google Scholar
[27] Malyshev M V, Donnelly V M 2000 J. Appl. Phys. 88 6207
 Google Scholar
Google Scholar
[28] Malyshev M V, Donnelly V M 2000 J. Appl. Phys. 87 1642
 Google Scholar
Google Scholar
[29] Thorsteinsson E G, Gudmundsson J T 2010 Plasma Sources Sci. Technol. 19 015001
 Google Scholar
Google Scholar
[30] Thorsteinsson E G, Gudmundsson J T 2010 J. Phys. D: Appl. Phys. 43 115201
 Google Scholar
Google Scholar
[31] Thorsteinsson E G, Gudmundsson J T 2010 J. Phys. D: Appl. Phys. 43 115202
 Google Scholar
Google Scholar
[32] Thorsteinsson E G, Gudmundsson J T 2010 Plasma Sources Sci. Technol. 19 055008
 Google Scholar
Google Scholar
[33] Gudmundsson J T, Hjartarson A T, Thorsteinsson E G 2012 Vacuum 86 808
 Google Scholar
Google Scholar
[34] Zhang Y R, Zhao Z Z, Xue C, Gao F, Wang Y N 2019 J. Phys. D: Appl. Phys. 52 295204
[35] Liu W, Wen D Q, Zhao S X, Gao F, Wang Y N 2015 Plasma Sources Sci. Technol. 24 025035
 Google Scholar
Google Scholar
[36] 范惠泽, 刘凯, 黄永清, 蔡世伟, 任晓敏, 段晓峰, 王琦, 刘昊, 吴瑶, 费嘉瑞 2017 真空科学与技术学报 37 286
 Google Scholar
Google Scholar
Fan H Z, Liu K, Huang Y Q, Cai S W, Ren X M, Duan X F, Wang Q, Liu H, Wu Y, Fei J R 2017 Chin. J. Vac. Sci. Technol. 37 286
 Google Scholar
Google Scholar
[37] Smith S A, Lampert W V, Rajagopal P, Banks A D, Thomson D, Davis R F 2000 J. Vac. Sci. Technol., A 18 879
 Google Scholar
Google Scholar
[38] Lee J M, Chang K M, Lee I H, Park S J 2000 J. Vac. Sci. Technol., B 18 1409
 Google Scholar
Google Scholar
[39] Taube A, Kamiński M, Ekielski M, et al. 2021 Mater. Sci. Semicond. Process. 122 105450
 Google Scholar
Google Scholar
[40] Chung C W, Chung I 2000 J. Vac. Sci. Technol., A 18 835
 Google Scholar
Google Scholar
[41] Park J S, Kim T H, Choi C S, Hahn Y B 2002 Korean J. Chem. Eng. 19 486
 Google Scholar
Google Scholar
[42] Kwon K H, Efremov A, Yun S J, Chun I, Kim K 2014 Thin Solid Films 552 105
 Google Scholar
Google Scholar
[43] Kang S, Efremov A, Yun S J, Son J, Kwon K H 2013 Plasma Chem. Plasma Process. 33 527
 Google Scholar
Google Scholar
[44] Tinck S, Boullart W, Bogaerts A 2009 J. Phys. D: Appl. Phys. 42 095204
 Google Scholar
Google Scholar
[45] Tinck S, Boullart W, Bogaerts A 2011 Plasma Sources Sci. Technol. 20 045012
 Google Scholar
Google Scholar
[46] Tinck S, Bogaerts A, Shamiryan D 2011 Plasma Processes Polym. 8 490
 Google Scholar
Google Scholar
[47] Hsu C C, Coburn J W, Graves D B 2006 J. Vac. Sci. Technol., A 24 1
 Google Scholar
Google Scholar
[48] Efremov A, Amirov I, Izyumov M 2023 Vacuum 207 111664
 Google Scholar
Google Scholar
[49] Hsu C C, Nierode M A, Coburn J W, Graves D B 2006 J. Phys. D: Appl. Phys. 39 3272
 Google Scholar
Google Scholar
[50] Schulze J, Schüngel E, Czarnetzki U 2012 Appl. Phys. Lett. 100 024102
 Google Scholar
Google Scholar
[51] Ahr P, Schüngel E, Schulze J, Tsankov T V, Czarnetzki U 2015 Plasma Sources Sci. Technol. 24 044006
 Google Scholar
Google Scholar
[52] Lieberman M A, Lichtenberg A J 2005 Principles of Plasma Discharges and Materials Processing (Hoboken, NJ, USA: John Wiley & Sons, Inc.) p268
[53] 张钰如, 高飞, 王友年 2021 70 095206
 Google Scholar
Google Scholar
Zhang Y R, Gao F, Wang Y N A 2021 Acta Phys. Sin. 70 095206
 Google Scholar
Google Scholar
[54] Yang W, Zhao S X, Wen D Q, Liu W, Liu Y X, Li X C, Wang Y N 2016 J. Vac. Sci. Technol., A 34 031305
 Google Scholar
Google Scholar
[55] Toneli D A, Pessoa R S, Roberto M, Gudmundsson J T 2015 J. Phys. D: Appl. Phys. 48 325202
 Google Scholar
Google Scholar
[56] Proto A 2021 Ph. D. Dissertation (Iceland: University of Iceland
[57] Stafford L, Khare R, Guha J, Donnelly V M, Poirier J S, Margot J 2009 J. Phys. D: Appl. Phys. 42 055206
 Google Scholar
Google Scholar
[58] Guha J, Donnelly V M 2009 J. Appl. Phys. 105 113307
 Google Scholar
Google Scholar
[59] Boyd R L F, Thomson J B 1959 Proc. R. Soc. London, Ser. A 252 102
 Google Scholar
Google Scholar
[60] Kokkoris G, Goodyear A, Cooke M, Gogolides E 2008 J. Phys. D: Appl. Phys. 41 195211
 Google Scholar
Google Scholar
[61] Dai Z L, Wang Y N, Ma T C 2002 Phys. Rev. E 65 036403
 Google Scholar
Google Scholar
[62] Dai Z L, Wang Y N 2004 Phys. Rev. E 69 036403
 Google Scholar
Google Scholar
[63] Dai Z L, Wang Y N 2002 Phys. Rev. E 66 026413
 Google Scholar
Google Scholar
[64] Dai Z L, Wang Y N 2002 J. Appl. Phys. 92 6428
 Google Scholar
Google Scholar
[65] Dai Z L, Wang Y N 2003 Surf. Coat. Technol. 165 224
 Google Scholar
Google Scholar
[66] Wen D Q, Zhang Q Z, Jiang W, Song Y H, Bogaerts A, Wang Y N 2014 J. Appl. Phys. 115 233303
 Google Scholar
Google Scholar
[67] Hong Y H, Kim T W, Kim B S, Lee M Y, Chung C W 2022 Plasma Sources Sci. Technol. 31 075008
 Google Scholar
Google Scholar
[68] Huang S, Gudmundsson J T 2013 Plasma Sources Sci. Technol. 22 055020
 Google Scholar
Google Scholar
[69] Hennad A, Yousfi M 2010 J. Phys. D: Appl. Phys. 44 025201
 Google Scholar
Google Scholar
[70] Manenschijn A, Janssen G C A M, Van Der Drift E, Radelaar S 1991 J. Appl. Phys. 69 1253
 Google Scholar
Google Scholar
[71] Hayden C, Gahan D, Hopkins M B 2009 Plasma Sources Sci. Technol. 18 025018
 Google Scholar
Google Scholar
[72] Gahan D, Dolinaj B, Hopkins M B 2008 Rev. Sci. Instrum. 79 033502
 Google Scholar
Google Scholar
[73] Edelberg E A, Aydil E S 1999 J. Appl. Phys. 86 4799
 Google Scholar
Google Scholar
[74] Edelberg E A, Perry A, Benjamin N, Aydil E S 1999 J. Vac. Sci. Technol., A 17 506
 Google Scholar
Google Scholar
[75] Edelberg E A, Perry A, Benjamin N, Aydil E S 1999 Rev. Sci. Instrum. 70 2689
 Google Scholar
Google Scholar
Catalog
Metrics
- Abstract views: 7023
- PDF Downloads: 411
- Cited By: 0















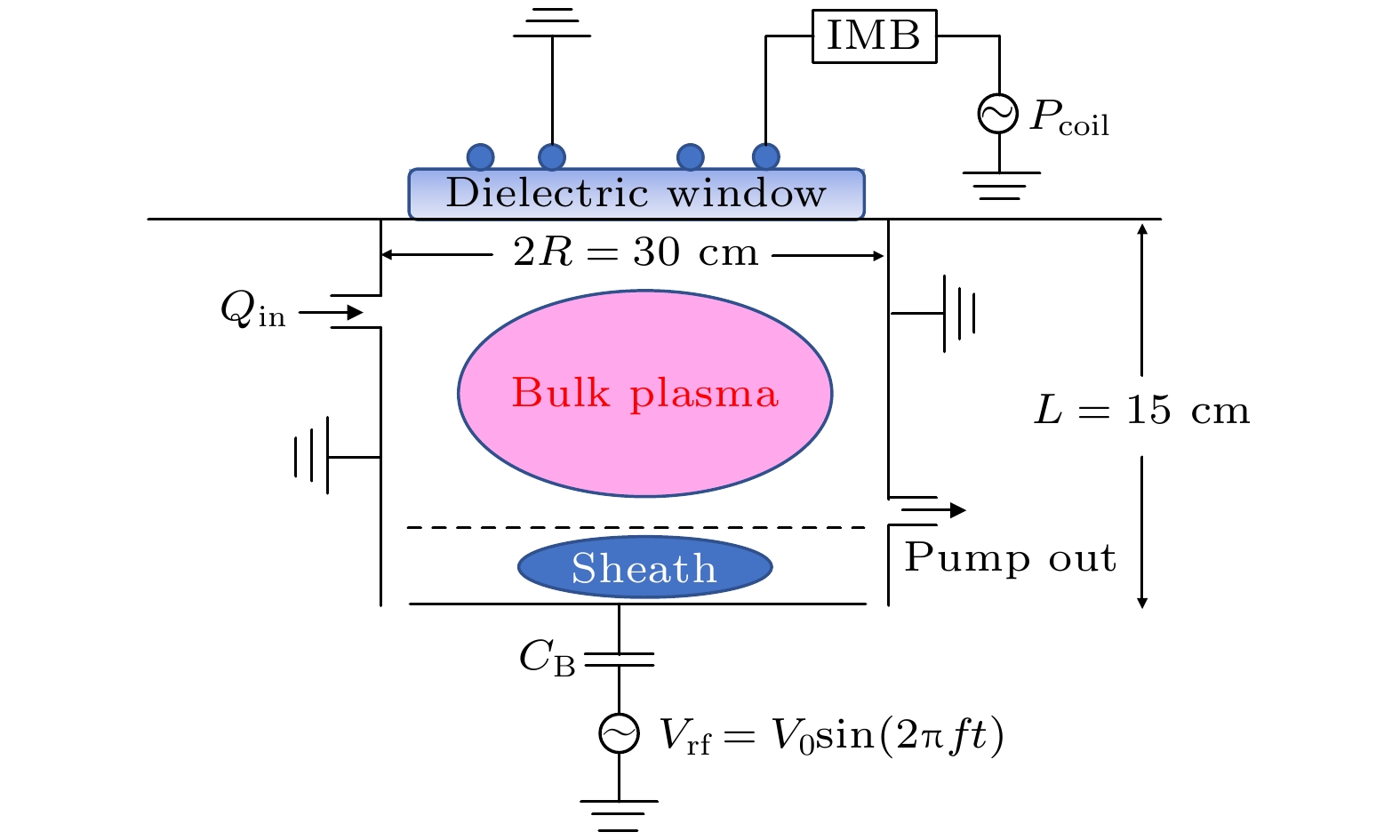
 DownLoad:
DownLoad: